一、引言
一顆芯片無法獨立工作,需要與其他元件和電路連接,以實現特定的功能。這個連接的過程就涉及到芯片封裝,封裝不僅將芯片與外部環境隔離,保護其免受物理和化學損害,還能增強其電性能,提高信號傳輸效率。本文將深入探討芯片封裝的意義、作用、類型及主要流程。
二、芯片封裝的意義
-
保護芯片:封裝的首要目的是保護芯片免受環境中的物理和化學因素(如機械壓力、溫度、濕度、化學腐蝕等)的影響。
-
信號傳輸:封裝還能提高芯片之間以及芯片與外部電路之間的信號傳輸效率,確保電子設備的正常運行。
-
增強性能:某些封裝方式還可以改善芯片的性能,例如通過優化散熱設計,提高芯片的可靠性和穩定性。
-
便于維修和更換:合適的封裝能使芯片更易于拆裝和更換,方便維修和更新。
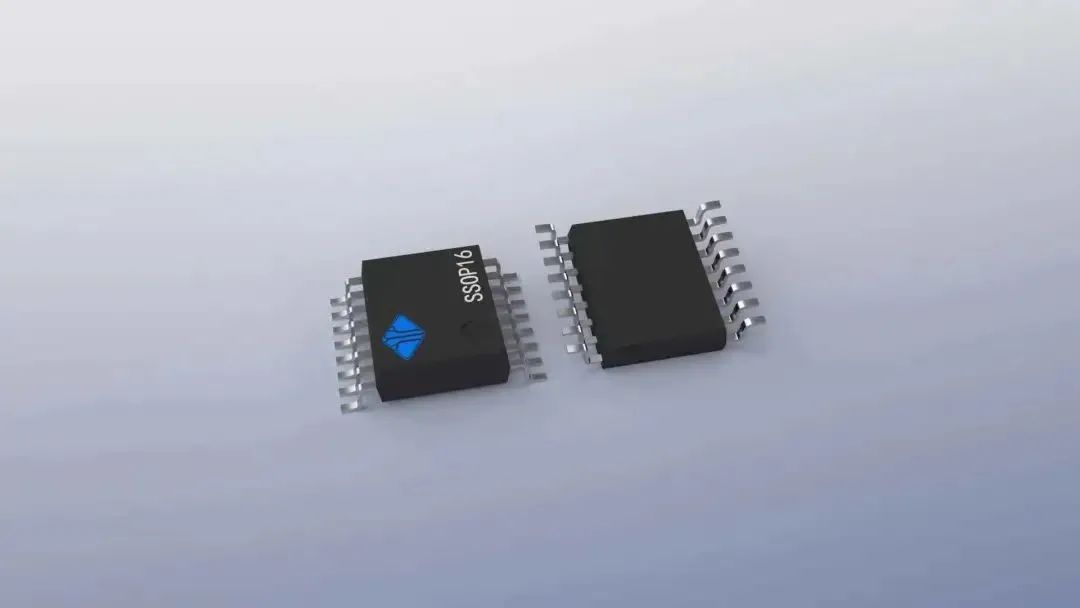
三、芯片封裝的作用
-
保護芯片免受環境因素影響:如前面所述,封裝可以保護芯片免受物理和化學損害。
-
提高信號傳輸效率:通過優化布線和連接設計,封裝可以提高信號傳輸的效率和穩定性。
-
增強芯片性能:某些封裝方式可以通過改善散熱設計、優化電源分布等手段,提高芯片的性能和穩定性。
-
方便維修和更換:封裝使得芯片的安裝和更換更為簡單方便,降低了維修成本。
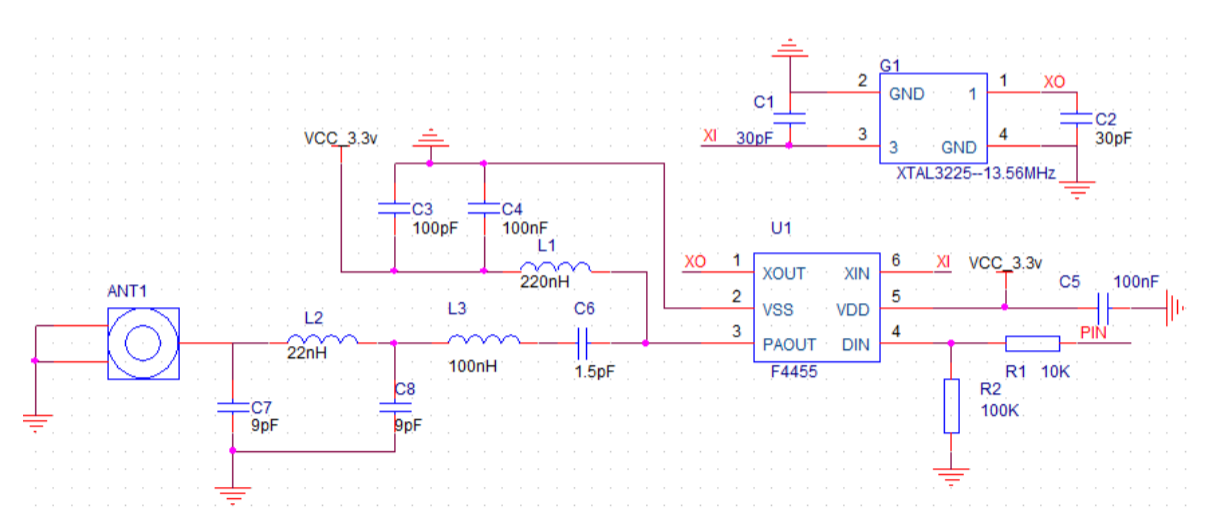
四、芯片封裝的類型
-
引線封裝:這是最常見的封裝類型,通過金屬引線將芯片連接到封裝體上。引線封裝又分為QFP(Quad Flat Package)、BGA(Ball Grid Array)等多種形式。
-
倒裝芯片封裝:倒裝芯片封裝是一種將芯片直接連接到電路板上的技術,無需使用引線。這種封裝類型可以提供更高的信號傳輸效率和更小的體積。
-
晶圓級封裝:晶圓級封裝是一種在整片晶圓上進行封裝的工藝,具有制造成本低、體積小等優點。常見的晶圓級封裝有 WLCSP(Wafer-Level Chip-Scale Package)和 Fan-Out WLCSP 等。
-
3D封裝:3D封裝是一種將多個芯片垂直堆疊在一起的封裝技術,可以實現更高的集成度和更小的體積。這種封裝類型廣泛應用于手機、平板電腦等便攜式設備中。
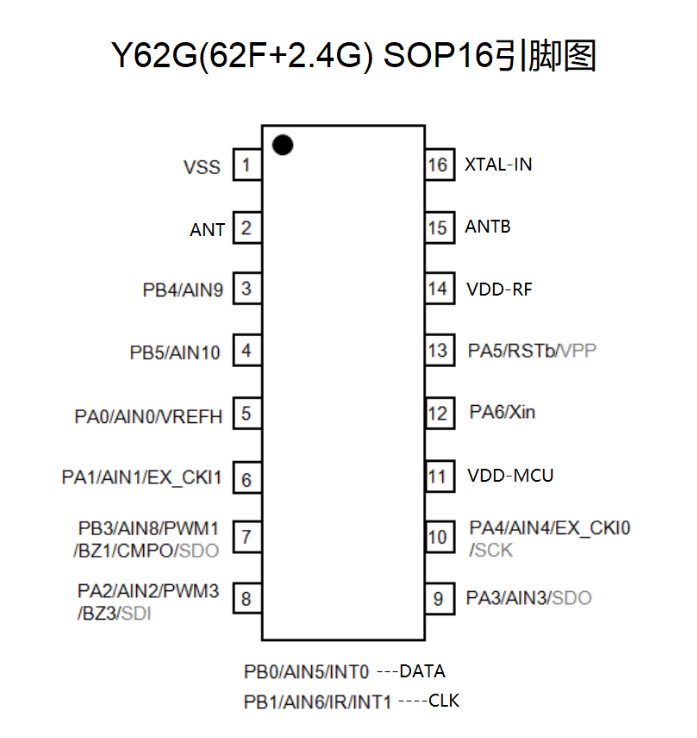
五、芯片封裝的主要流程
-
前處理:對芯片進行清洗、干燥等處理,確保其表面干凈無污染。
-
粘接:將芯片粘貼到基板上,常用膠水進行固定。
-
引線連接:通過焊接或壓接等方式將芯片的引線連接到基板上。
-
填充膠水:在芯片與基板之間填充膠水,以保護電路不受外界環境的影響,同時提高機械強度。
-
打磨和切割:對多余的引線和填充膠進行打磨和切割,確保封裝的平整和美觀。
-
檢測與老化測試:對封裝后的芯片進行檢測和老化測試,確保其性能和質量符合要求。
-
終檢與包裝:對合格的產品進行外觀檢查和功能測試,最后進行包裝出貨。
六、總結
芯片封裝在電子設備中具有重要意義,它不僅能保護芯片免受環境因素的影響,提高信號傳輸效率和穩定性,還能增強芯片性能和方便維修和更換。
隨著科技的不斷發展,封裝的類型和工藝也在不斷進步和完善,以滿足不同應用場景的需求。
您需要定制2.4G合封芯片、芯片封裝、芯片方案開發,直接“「宇凡微」”官-網領樣品和規格書。

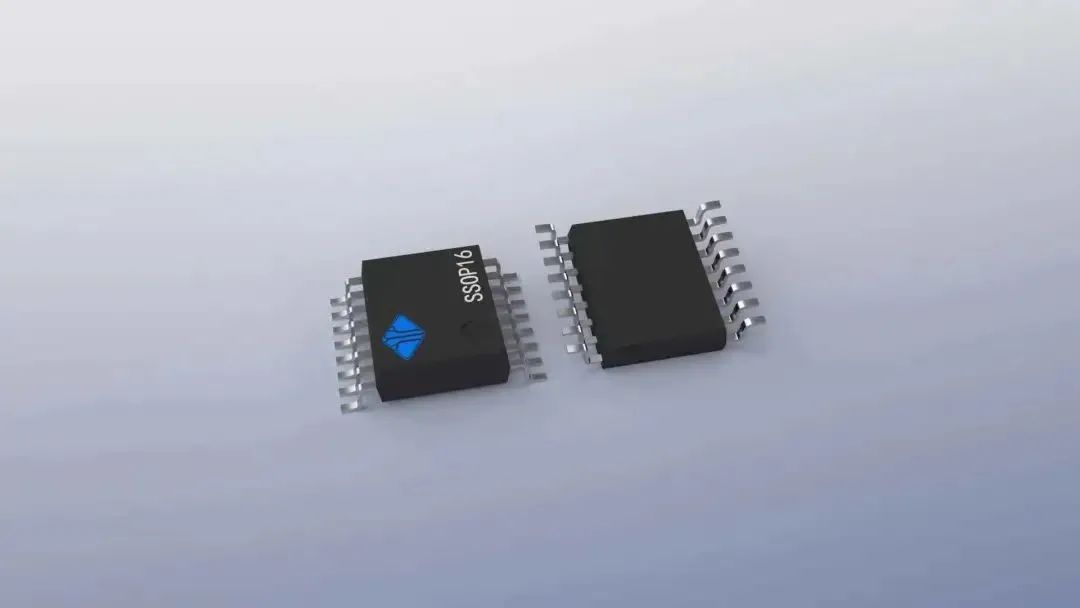
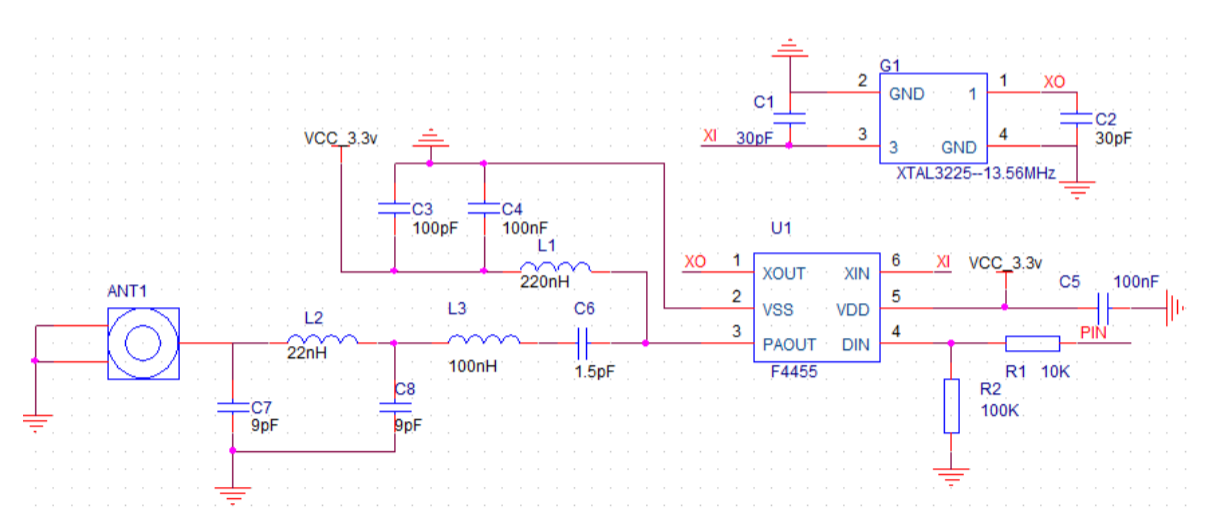
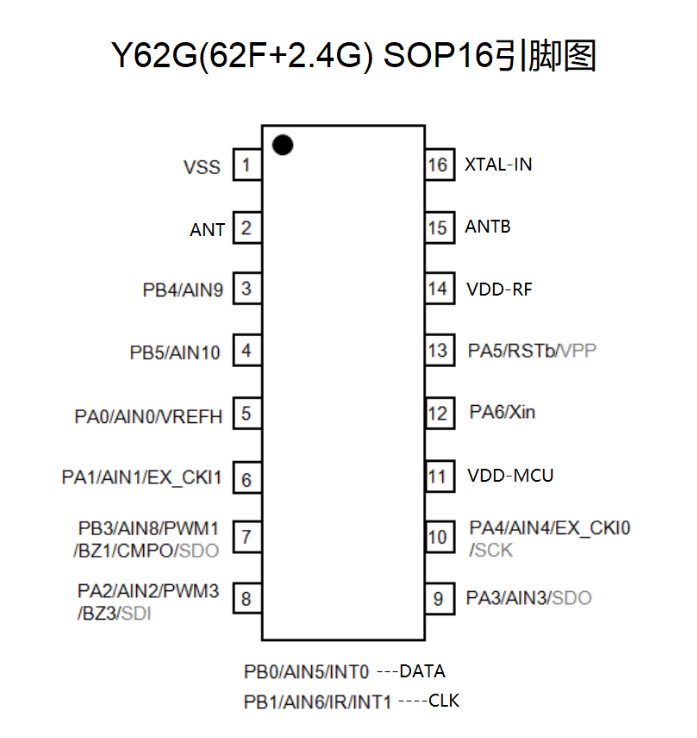

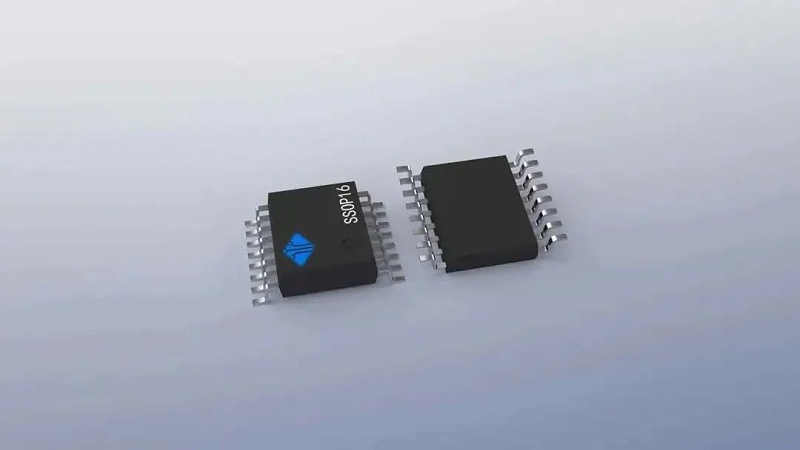
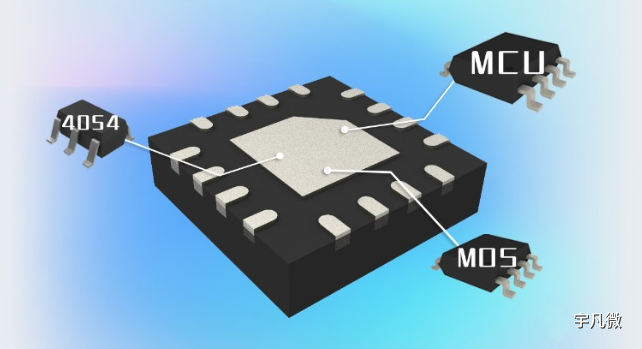

 微信二維碼
微信二維碼
 粵公網安備 44030402004503號
粵公網安備 44030402004503號